鎖相放大器在光電二極管同頻橫向偏轉特征信號檢測中的應用
浙江大學徐楊教授與胡歡教授團隊在國際微納研究期刊《Microsystems & Nanoengineering》上發表題為“Lateral deflection-based optimization achieves sub-picometer detection limit”的研究成果。該研究提出了一種適用于掃描探針顯微鏡(SPM)的普適性優化策略,通過巧妙利用原子力顯微鏡(AFM)探針的橫向偏轉信號,將位移測量的信噪比(SNR)提升了近一個數量級。該策略在掃描焦耳膨脹顯微鏡(SJEM)中成功實現了創紀錄的0.37pm位移檢測極限,空間分辨率最高可達10nm。
納米級表面微小位移的精確測量是揭示材料熱傳導、電學行為及光熱吸收特性的基礎。傳統的SPM技術通常通過測量探針因彎曲產生的“垂直偏轉”來檢測表面形變。然而,在檢測皮米量級的亞納米形變時,由彎曲引起的激光光斑位移極其微小,使得熱膨脹等有效信號往往被淹沒在環境背景噪聲中。盡管業界開發了多種定制化的特殊懸臂或探針來提高靈敏度,但這些特制探針不僅造價高昂,還面臨著與標準檢測系統不兼容的瓶頸,行業急需一種兼顧極高靈敏度與高普適性的位移測量解決方案。
為突破檢測極限的瓶頸,研究團隊創新性地提出了一種基于探針“橫向偏轉(Lateral deflection)”的優化測量策略。該方案的核心在于,利用探針接觸掃描時產生的“扭轉”運動來替代傳統的“彎曲”運動提取形變特征。從光學杠桿的物理放大機制來看,由于懸臂的幾何特性(懸臂長度L遠大于針尖高度h),同等幅度的表面形變通過探針扭轉在光電探測器上產生的橫向激光偏移量,遠遠大于通過探針彎曲產生的垂直偏移量。這種將縱向形變耦合進橫向扭轉的轉換機制,在物理源頭上實現了微小形變信號的數量級放大。研究團隊將這一創新策略成功部署在掃描焦耳膨脹顯微鏡(L-SJEM)系統中進行驗證。在L-SJEM的掃描過程中,系統向納米導線或薄膜樣品施加高頻交變電壓引發焦耳熱,從而在樣品表面產生周期性的熱膨脹。由于掃描時的法向力和摩擦力賦予了探針一個初始的扭轉角,這些由于熱源引發的局部形變會使得探針產生額外的動態扭轉變化。系統精準提取出這些交變的橫向偏轉信號,從而構建出極高分辨率的器件焦耳熱分布三維映射模型。
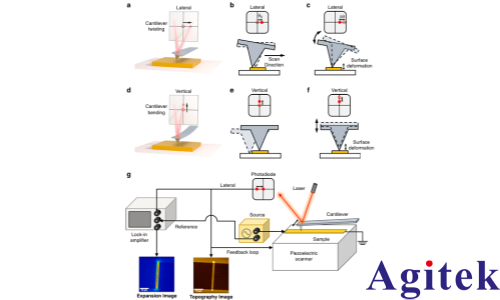
圖1.光電探測器上顯示的懸臂響應。
(a)扭轉示意圖。(b)橫向偏轉。(c)激勵引起的額外橫向偏轉。
(d)彎曲示意圖。(e)垂直偏轉。(f)激勵引起的額外垂直偏轉。
(g)L-SJEM系統示意圖。
該系統由以下部分組成:壓電位移掃描模塊、Z傳感器反饋環、光電二極管、鎖相放大器以及提供交變電壓的源。
AFM探針在接觸模式下檢測這種膨脹。

圖2.樣品A和B的形貌、SJEM圖像以及模擬溫度場。
(a)樣品A掃描區域的形貌。(b)樣品A基于垂直偏轉的SJEM和(c)L-SJEM圖像。
(d)模擬溫度場,樣品B(e)基于垂直偏轉的SJEM和(f)L-SJEM圖像。
(g)焦耳膨脹輪廓。左上角插圖顯示了樣品B的SEM圖像。右下角插圖描繪了溫度場的三維映射。藍色實線、紅色實線和黑色點劃線分別代表在黑色虛線位置從垂直偏轉、橫向偏轉和模擬中獲得的熱膨脹信號。
為便于比較,信號已歸一化。分別基于(b,c)中白色虛線處的(h)垂直偏轉和(i)橫向偏轉提取的焦耳膨脹曲線。

圖3.樣品A的熱膨脹響應與法向力的關系。
(a)在樣品A中測得的熱膨脹隨法向力增加的變化關系。
紅、黑空心圓分別代表在不同法向力下,基于橫向和垂直偏轉測量同一形變獲得的熱膨脹信號。
紅色實線是對探針與樣品表面達到穩定法向力區域的數據進行的線性擬合。
紅色區域代表從線性區域內的殘差計算得出的±2σ偏差極限(經驗95%覆蓋率)。
(b)探針扭轉角與法向力之間關系的示意圖。在法向力分別為(c)22nN、(d)65nN和(e)218nN時獲取的L-SJEM圖像。
對比測試清晰地展示了該策略的卓越性能:與傳統的垂直偏轉法相比,L-SJEM將系統信噪比(SNR)從20躍升至168。由于極低的本底噪聲,L-SJEM將熱膨脹檢測的下限成功推進至創紀錄的0.37pm。更具優勢的是,由于這種扭轉響應機制,系統可以通過簡單調節掃描法向力來靈活調控測量靈敏度;并能通過對比“去向掃描(Trace)”和“回向掃描(Retrace)”的信號差異,完美解耦出同一位置的面內(In-plane)與面外(Out-of-plane)兩組獨立熱膨脹矢量特征。該技術隨后在石墨烯中鎵離子束輻照引發的極細微缺陷檢測定位中得到了完美的實際驗證。
這項研究提出了一種完全建立在標準AFM探針架構上的高靈敏度位移檢測新范式,徹底擺脫了對昂貴特制探針的依賴。其靈活的靈敏度調控和多維形變解耦能力,使得該橫向偏轉策略能夠非常容易地作為一種獨立模塊,集成至現有的商用AFM系統平臺中。未來,該策略可移植應用于壓電響應力顯微鏡(PFM)、光誘導力顯微鏡等其他依賴接觸掃描的測量技術中,為微納電子學和先進材料的高精度表征提供通用儀器升級方案。
技術支持
















 關注官方微信
關注官方微信
